2026-02-13
纳米银烧结银胶
环氧树脂基高导热烧结银胶(Epoxy-Based High Thermal Conductivity Sintered Silver Adhesive)结合了热固性环氧基体的机械稳定性与烧结银颗粒的高热导特性,广泛应用于功率模块封装、LED热管理、与车用电子领域。该材料系统通过将纳米或微米级银颗粒分散于功能化环氧基体中,并在低于300 °C的温和条件下进行部分烧结(Low-Temperature Sintering),形成连续银网络,有效提升热导率至20–100 W/m·K以上,同时保有优异的机械粘结力。
烧结型银胶能大幅降低材料成本与加工粘度,并提升可靠性与耐湿性,在多循环热冲击(−40 °C至150 °C)下仍保有稳定电性与粘着强度,为实现车用、高频或极端环境下电子元件封装的关键材料之一。综合而言,高导热烧结银胶兼具高热导、高可靠与低温加工潜力,已成为次世代高性能导热界面材料的研究焦点。
◆ 半烧结银胶 (Semi-sintered)
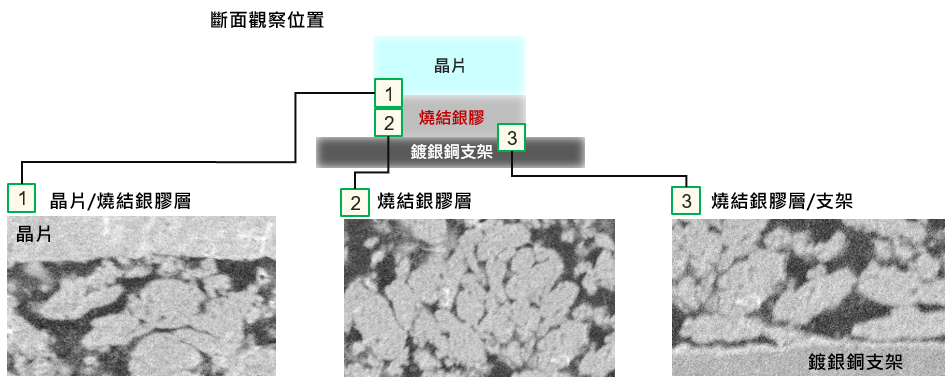
◆ 全烧结银胶 (Fully-sintered)
肥特补纳米级全烧结固晶银浆 - FP-6100-HP9,可用于需要高导电与高导热的半导体封装设计。为了获得最佳性能,所使用的芯片和基板必须镀金或镀银。不含树脂成分,以纯金属粘接,显著提升产品的导热性。
产品应用:
1. 高功率的封装产品。
2. 在高温环境工作的封装产品。
3. SIP/QFN/LGA/HBLED
产品特点:
1. 极佳的高温推力;极佳的导电能力。
2. 适合用于涂胶与点胶工艺。
3. 极佳的导热能力。
4. 可低温烧结 (180-200℃)。